M6米乐手机登录APP入口 探讨FCBGA基板技术的发展趋势及应用前景
2024-06-02 07:30:31 1
等高端数字芯片的重要载体,业界对其的需求量快速增长。对FCBGA基板的关键技术进行了介绍,包括精细线路技术、翘曲控制技术和局部增强技术。同时,对FCBGA基板技术的发展趋势及应用前景进行了展望。
基板又称集成芯片载板,为芯片提供电气互连、保护、支撑、散热、组装等功效,作为连接裸芯片与PCB的桥梁,是集成电路产业中封装产品的关键原材料之一。基板和芯片有多种封装形式,其中倒装芯片球栅格阵列(FCBGA)基板是针对AI、5G、大数据、高性能计算(HPC)、智能汽车和数据中心等新兴需求应用的CPU、图形处理器(GPU)、FPGA等高端数字芯片的重要载体,具有高算力、高速度、高带宽、低延迟、低功耗、多功能和系统级集成等许多优点。
以栅格阵列形式倒装的基板包含针脚栅格阵列(PGA)、平面栅格阵列(LGA)、球栅格阵列(BGA)3种类型。Prismark预测的2011—2026年封装基板市场形势如图1所示,从2011年至2026年,FCPGA/LGA/BGA基板在封装基板市场中的占比一直是最多的,均在45%以上,在2026年将达到57%;2026年基板市场规模将达到214亿美元,2021至2026年这5年的预计年均复合增长率达到8.3%,其中FCBGA市场规模达到121亿美元,占比在一半以上,年复合增长率在基板市场中最高,达到11.5%。可见,未来封装基板市场中最为活跃的就是FCBGA基板市场。目前我国基板厂已经具备引线键合球栅格阵列(WBBGA)、倒装芯片级封装(FCCSP)等中低端基板制造能力,但高端的FCBGA基板量产市场仍被日韩及中国地区企业所垄断。
近些年,我国相关行业也在该领域进行大量投入,其中深南电路、兴森快捷、安捷利美维等基板厂已在存储、射频等FCBGA基板方向进行大额资金投入和先进技术研发,中国科学院微电子研究所建立了国内唯一的先进基板研发线,在FCBGA基板方面已实现精细线路与埋入式功能基板成套技术,形成支撑AI、HPC系统封装集成应用的大尺寸基板(70 mm×70 mm以上)、大尺寸芯片(25 mm×25 mm以上)、大功率(1000 W以上)以及大功率密度(1.5 W/mm2)的样品。
FCBGA基板技术不同于普通基板。首先,随着数据处理芯片的尺寸增加到70 mm×70 mm,配套的FCBGA基板从80 mm×80 mm向110 mm×110 mm的更大尺寸过渡。其次,面向高密度互连的需求,基板增层[指在芯板(Core)两侧的增层布线层,不包含芯板上的两层线层甚至更多。同时,为实现高密度布线 μm以下。综上,FCBGA基板具有超大尺寸、高叠层和精细线个方面的特点。超大尺寸和高叠层在基板工艺上的突出表现为翘曲增加,同时线路节距减少,需要新的基板材料、新工艺和新结构形式的引入,所以FCBGA基板关键技术的研究主要包括精细线路技术、翘曲控制技术和局部增强技术3个方面。
精细线路的主要载体为具有低粗糙度表面的绝缘介质,常规选用工艺为半加成工艺(SAP),该工艺主要考察介质材料与金属种子层间结合力的控制问题,结合力的强弱对精细线路的附着起到决定性作用。因此,针对上述关键因素进行重点介绍,包括增层介质材料、工艺方法和结合力控制技术3个方面。
基板的增层介质材料有多种,包括双马来酰亚胺三嗪(BT)树脂、半固化片(PP)、涂树脂铜箔(RCC)、光敏绝缘材料和味之素增层膜(ABF)等。PP由玻纤布和树脂构成,其表面的粗糙度来自压合时的铜箔毛牙,超低粗糙度的铜箔表面平均粗糙度在0.5 μm以上,通常在改良半加成工艺(MSAP)中用于制作15 μm以上的线路。受到玻纤束经纬交织的影响,盲孔的成孔直径在65 μm以上。RCC是在铜箔表面涂覆树脂,其粗糙度同样来源于铜箔,因其不含玻纤或填料,受温湿度影响的涨缩比较大,不适合用于大尺寸、高叠层基板的制作;光敏绝缘材料由树脂、填料和感光溶剂等组成,通过光刻工艺可实现小于25 μm的超小盲孔,但在使用中其表面的种子层通常需要通过半导体工艺沉积,工艺兼容性相对较差。ABF是一种由高分子树脂、硅微粉和溶剂等物质混合形成的复合薄膜材料,通过除胶工艺控制其表面粗糙度(通常小于0.4 μm),采用常规基板工艺即可以直接镀铜,形成线μm的精细线路。因为填料采用均匀分布的平均直径不大于0.5 μm的硅微粉,可以实现孔径为25~30 μm的高密度盲孔。总的来说,相比于其他增层介质,ABF具有易于加工和较高的工艺兼容性等特点,因此被广泛用作FCBGA基板的增层介质材料。
为了满足高密度布线、高速传输和高叠层基板低翘曲的需求,ABF的物性不断提升,从GX系列到GL系列,随着硅粉填料的质量分数从38%增加到72%,热膨胀系数(CTE)从46×10-6·℃-1降低到20×10-6·℃-1,减小一半以上;杨氏模量从4 GPa提高到13 GPa,介电损耗降低4倍。ABF基本物性参数对比如表1所示。表面粗糙度与精细线所示,可以看出介质表面的粗糙度对线宽/线间距的影响。当介质表面的粗糙度较大时,图形电镀中有渗镀风险,在细线路的底部易形成微短或短路,不利于细线路的线形控制。随着线路节距的缩小,介质表面的粗糙度也相应减小,因此,ABF中硅微粉的平均直径从0.5 μm下降到0.1 μm时,相应的表面粗糙度从400 nm下降到100 nm及以下。
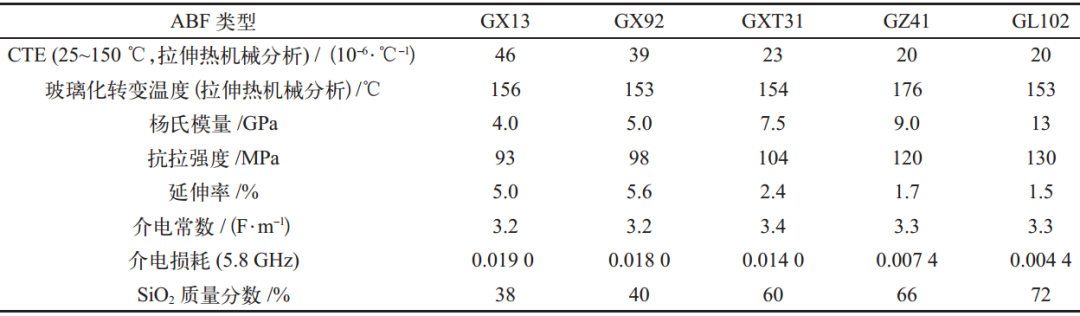
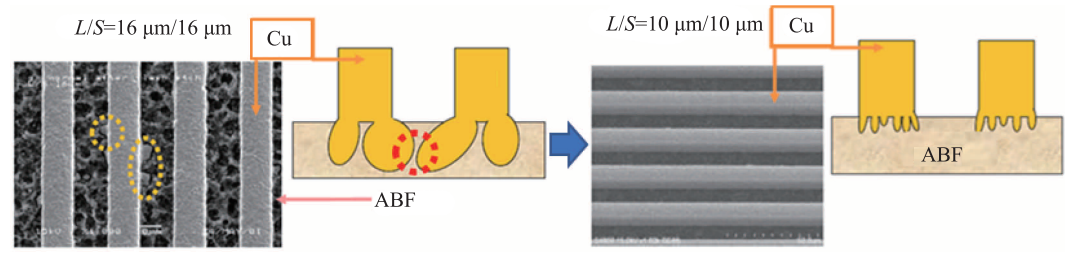
精细线路通常选用SAP工艺实现,SAP与MSAP工艺流程如图2所示,SAP工艺是将内层基板做超粗化处理以增强介质和下层金属线路间的结合力,在基板两面贴增层介质,通过真空压膜和镜面钢板整平获得均匀覆盖在基板表面的介质层,激光钻孔后对介质表面做除胶工艺处理,清除钻孔产生的残渣并形成均匀的、纳米尺度的粗糙表面,在孔内及介质表面沉积疏松的化铜层,再经过图形发生(包括贴膜、曝光、显影工艺)和图形转移(包括图形电镀、剥膜和闪蚀)等一系列工艺形成增层线路。
SAP和MSAP的最大区别在于绝缘介质上的种子层。SAP中绝缘介质表面的种子层是通过化铜工艺沉积厚度约为1 μm、比电解铜疏松的化学铜,而MSAP中绝缘介质表面的种子层是和介质一起压合的电解铜箔(厚度为2~3 μm)。由于闪蚀药水的蚀刻选择性,超薄又疏松的化铜层比电解铜更易去除,更利于实现高密度线路。但如果种子层与介质间的结合力弱,细线路在剥膜、闪蚀及超粗化处理等工艺中经过多次有压力的药液冲击,会出现飞线、掉线等不良现象,尤其对于大尺寸基板上长度为几十毫米的长距精细线路来说,其掉线现象会非常严重。所以SAP工艺的核心技术,也是通过使用无铜箔增层介质材料实现精细线路的前提条件,即控制化铜层与介质材料间的结合力。
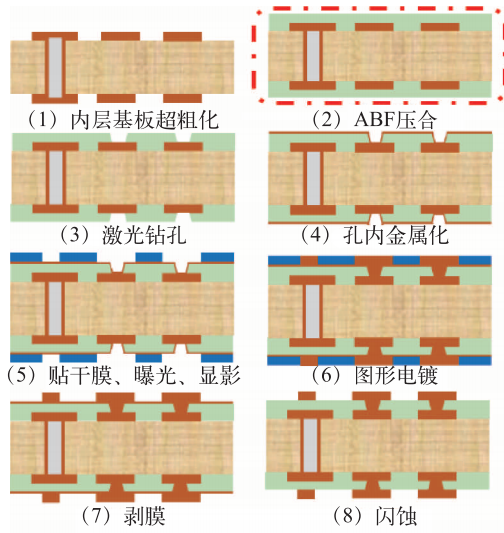
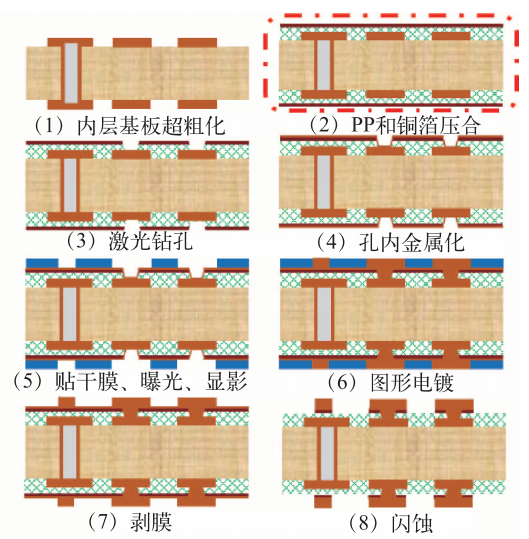
增层介质材料作为隔离上下两层金属线路的绝缘层,若其与下层线路的结合力弱,多层基板易在制备过程或可靠性测试中,因温度、湿度等环境条件的变化出现爆板、分层等不良情况。若其与上层金属的结合力弱,则在图形发生和转移工艺中就会出现线路倒伏、剥落,无法完成多层基板的制作。
通过对线路做超粗化处理来实现介质材料与下层线路的良好结合,采用粗化药水对铜晶界进行有选择性的刻蚀,在铜晶粒表面形成独特的凹凸形状,超粗化的电镀铜表面如图3所示,可以在控制对精细线路的蚀刻量的同时,提高线路铜和树脂间的物理结合力。然后在超粗化的铜表面增加有机膜,利用有机膜、铜及树脂间的共价键可以提高线路铜和树脂间的化学结合力。

介质材料与上层线路结合力的控制涉及一系列工艺,包括材料的回温取用时间、压合参数、固化条件、除胶工艺,需根据材料的物化性质和固化机理的不同,优化介质材料使用时的全套工艺参数。其中除胶工艺决定了介质表面的最终处理状态,包含3个步骤:1)蓬松,打散高分子树脂中的C—C键,降低键能,形成蜂窝状结构,使树脂易受高锰酸盐蚀刻液咬蚀;2)除胶,利用碱性高锰酸盐蚀刻溶液除去内层钻污,清洁孔壁并且粗化树脂,形成几百纳米不等的粗糙表面;3)中和,除去除胶段反应的残留物并清洗残留的松散硅微粉。
因为设备及药水差异,同种材料的除胶工艺参数差别较大,但最终获得的介质表面状态是一致的。具体表现为树脂和硅微粉均匀分布、纳米级粗糙度的表面形貌,测量结合力的办法参照IPC650相关标准。以GZ系列为例,其中树脂为环氧树脂和氰酸酯树脂,相较于GX系列的环氧和苯酚硬化剂更难刻蚀,并且介质中的硅微粉填料质量占比达到66%。不同除胶工艺铜剥离后的介质表面如图4所示,中科院微电子所研究结果表明,当除胶不足时,介质表面有多处树脂平坦区域,部分较大尺寸的硅微粉剥落,这种形貌时对应的结合力仅为0.15 N/mm,如图4(a)所示;当除胶过量时,表面硅粉剥落的同时有大量硅粉半露在表面,虽然表面的粗糙度增加,但因表面硅粉面积占比较大,这时的结合力仍偏低,只达到0.23 N/mm,若采用玻璃蚀刻剂对硅粉做微蚀处理,在硅粉和树脂间制造空隙即形成“锚定效应”,也可以提高结合力;当除胶适量时,介质表面有树脂和松散硅粉剥落形成的粗糙度,同时表面剩余的硅粉被树脂包裹,或硅粉的大部分体积埋入树脂中,化铜工艺中的催化剂离子钯与树脂的吸附性优于玻璃,利用其优异的吸附性,可以获得化铜层和介质材料的较高结合力(0.4 N/mm以上),满足精细线路工艺对无铜箔增层介质结合力的需求(通常为0.4~0.6 N/mm)。
翘曲是由于片状结构中不同组成部分间的CTE差异,在制造过程中,各个部分随温度变化涨缩不同,产生的
应力不同,造成片状结构表面起伏。严重的基板翘曲会导致2个重要的问题:一是严重的翘曲导致无法封装或封装失效,最直接的结果是倒装焊的焊球局部无法与PCB连接,或相邻焊球间发生桥接;二是过大的基板翘曲导致封装后的基板与芯片间存在较大应力,过大的应力导致焊球开裂、芯片开裂等可靠性问题。因材料特性不同,基板翘曲有一定的不确定性,但通过材料及结构的设计也可以实现对翘曲的控制。
FCBGA封装基板翘曲是因为铜线路、绝缘树脂以及芯板间CTE失配产生的应力不平衡造成基板形状改变。大部分相关文献都是关于封装后基板的翘曲
和讨论,对封装前的FCBGA基板翘曲的讨论非常少。由于基板材料中含有大量的高分子材料,而这些材料的物理性质随加工工艺和热处理(比如回流、固化等条件)的差异,参数变化较大,很难得到如同金属一样的一致性。LIN等人对于多家供应商提供的用于叠层封装(POP)的具有相同结构设计的基板(共5种基板),进行了封装前和回流后的翘曲测量数据对比。选用一个12 mm的方形POP封装用基板做设计,其中Core厚度为0.15 mm,采用低CTE材。
下一篇: 危险废物 登记贮存运输及处置流程规定
 中文
中文  ENGLISH
ENGLISH 
